
在半导体制造业中,薄膜的厚度对器件的性能和质量有重要影响。薄膜的厚度决定了许多重要的物理和化学性质,对其折射、反射和透射的光学性质有直接影响,可以导致显著的量子尺寸效应,从而改变材料的电子、光学和磁性等。准确测量和控制薄膜厚度对于优化器件性能、提高生产效率、确保器件可靠性等都具有重要的作用。
膜厚测量可以根据薄膜材料划分为两个基本类型,即不透明薄膜(金属类)和透明薄膜。测量不透明薄膜厚度的方法通常是通过测量方块电阻,通过其电阻与横截面积得到其膜厚,采用的设备一般为四探针台,将四根探针等距离放置,通过对最外两根探针施加电流,从而测量其电势差计算被测薄膜的方块电阻。而透明薄膜则通常基于椭圆偏振技术,对光谱范围内的偏振变化进行分析,各种薄膜层提供高精度薄膜测量。由于膜应力、折射率等物理性质同样需要椭圆偏振及干涉技术进行测量,因此目前主流的膜厚测量设备同时集成了应力测量、折射率测量等功能。
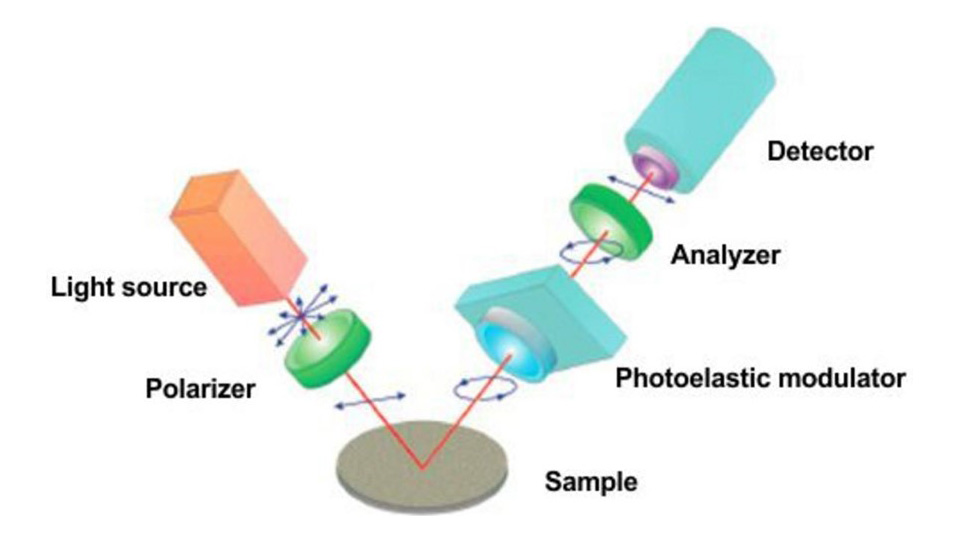
图1. 椭圆偏振测量原理示意图
针对晶圆膜厚测量设备,隐冠半导体可以提供尺寸极为紧凑的运动平台解决方案,灵活且有效支撑客户的集成式或者独立式膜厚测量解决方案。该运动平台采用创新性的双轴耦合设计理念和独特的大行程磁浮重力补偿技术,降低了垂向电机的载荷,很大程度提高了垂向运动性能和寿命。此外,我们还提供配套的驱控系统和减振系统,实现高吞吐量的量测能力。隐冠半导体拥有覆盖全国主要城市的售后团队,为您提供全方位的技术支持。